Jak donosi Korea Economic Daily, które powołuje się na ogłoszenie firmy wygłoszone na Samsung Foundry Forum 2024 w San Jose, a także „źródła branżowe”, Samsung ma wprowadzić w tym roku usługi pakowania 3D dla pamięci HBM. Pakowanie 3D dla HBM zasadniczo toruje drogę do integracji HBM4 pod koniec 2025–2026, ale nie jesteśmy pewni, jaki rodzaj pamięci Samsung zaoferuje w tym roku.
Do pakowania 3D Samsung oferuje platformę o nazwie SAINT (Samsung Advanced Interconnect Technology), która obejmuje trzy różne technologie układania stosów 3D: SAINT-S dla pamięci SRAM, SAINT-L dla logiki i SAINT-D dla układania pamięci DRAM na chipach logicznych, takich jak CPU lub GPU. Firma pracuje nad SAINT-D od kilku lat (a formalnie ogłosiła to w 2022 r.) i wygląda na to, że technologia będzie gotowa w tym roku, co będzie znaczącym kamieniem milowym dla największego na świecie producenta pamięci i jednej z największych odlewni.
Samsung ma wprowadzić w tym roku usługi pakowania 3D dla pamięci HBM.
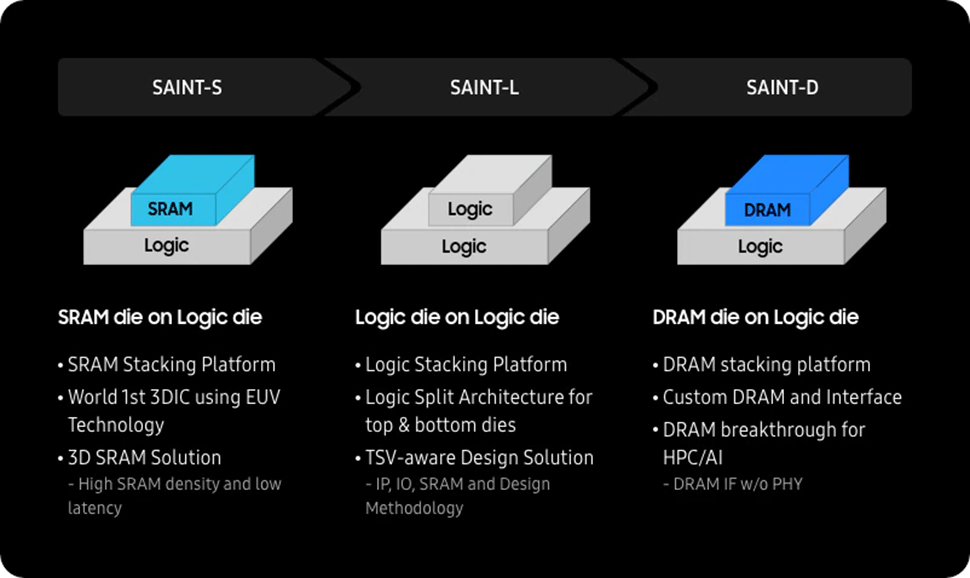
Nowa metoda pakowania 3D Samsunga polega na układaniu chipów HBM pionowo na procesorach, co różni się od istniejącej technologii 2,5D, która łączy chipy HBM i układy graficzne poziomo za pomocą krzemowego interposera. To podejście do układania w stosy pionowe eliminuje potrzebę stosowania interposera, ale wymaga nowej matrycy bazowej dla pamięci HBM, wykonanej przy użyciu zaawansowanego procesu technologicznego.
Technologia pakowania 3D oferuje HBM znaczące korzyści, w tym szybsze przesyłanie danych, mniejsze zakłócenia sygnałów, zmniejszone zużycie energii i mniejsze opóźnienia, ale przy stosunkowo wysokich kosztach. Samsung planuje oferować tę zaawansowaną technologię pakowania 3D HBM jako usługę „pod klucz”, w ramach której jego dział pamięci produkuje chipy, a jednostka odlewnicza montuje rzeczywiste procesory dla firm bez własnych odlewni.
Niejasne pozostaje, co dokładnie Samsung planuje zaoferować w tym roku wraz z SAINT-D. Umieszczenie HBM na kości logicznej wymaga odpowiedniego projektu chipa i żadna z firm nie zapowiedziała jeszcze procesorów, które miałyby otrzymać HBM na wierzchu i zadebiutują w tym roku lub pierwszej połowie przyszłego.

Patrząc w przyszłość, Samsung zamierza do roku 2027 wprowadzić wszechstronną technologię heterogenicznej integracji. Ta umożliwi integrację dwóch warstw układów logicznych, pamięci HBM (na interposerze), a nawet optyki co-package (CPO).












Pokaż / Dodaj komentarze do: Przełomowa technologia Samsunga układania pamięci HBM na CPU lub GPU zadebiutuje w tym roku